Institut Silizium-Photovoltaik
Constant Final State Yield Spektroskopie
für die Photoelektronenspektroskopie an amorphem Silizium
Grundlagen
Im Gegensatz zu Isolatoren und kristallinen Halbleitern besitzt amorphes Silizium auch in der Bandlücke, d.h. oberhalb der Valenzbandkante, noch elektronische Zustände, die durch die Verspannung des amorphen Netzwerks und das Aufbrechen von Si-Si Bindungen entstehen. Mit Zustandsdichten unter 1020 eV-1cm-3 (im Vergleich zu >1021 eV-1cm-3 im Valenzband) fallen sie unter die Nachweisgrenze der konventionellen UPS-Spektroskopie. Mit Hilfe der Constant-Final-State-Yield-Spektroskopie (CFSYS) [1-3] sind diese Zustandsdichten noch messbar. Bei der CFSYS ist die Energie der eingestrahlten Photonen Ephot die Variable, die kinetische Energie Ekin, bei der der Analysator die emittierten Elektronen detektiert, dagegen die feste Größe. Ekin wird so gewählt, dass die Elektronen detektiert werden, die gerade die Austrittsarbeits-Barriere ΦProbe von der Probe in den Außenraum überwinden können.
Messaufbau
Um Ephot zu variieren, wird eine Xe-Hochdrucklampe mit Doppelmonochromator benutzt, die eine ausreichende Helligkeit (Photonenfluss), bis ca. 7 eV (UV), liefert. Damit liegt das von der CFSY-Spektroskopie erreichbare Energieintervall von der Fermikante (Ebind=0) bis (Ebind=−7eV−FProbe) bei ca. −3,5 eV, d.h. nur Zustände in der Bandlücke (a-Si:H: Egap~1,7 eV) und im bandkantennahen Valenzband sind der Messung zugänglich.
Vorteil
Der Vorteil dieser Spektroskopie liegt nun in der vergleichsweise großen Informationstiefe, d.h. der maximalen Generationstiefe des Photoelektrons, bei der dieses noch die Probenoberfläche erreichen und die Probe verlassen kann, um im Analysator detektiert zu werden. Bei Energien der Photoelektronen von 4-7 eV ist die für diese Informationstiefe wesentliche mittlere freie Weglänge der Elektronen zwischen inelastischen Stößen λimpf~5-10 nm ², bei Anregung mit Ephot=21,2 eV (He I) dagegen ~0,5 nm. Mit der UV-PES ist es daher möglich, eine gemittelte Zustandsdichte für die obersten ~10 nm einer Probe zu messen. Damit ist sie optimal geeignet, die a-Si-Emitterschichten mit Dicken um 5-10 nm, wie sie in der aSi/cSi-Heterostruktur-Solarzelle verwendet werden, hinsichtlich ihrer Zustandsdichte NOCC(E) bis hinunter zu 1015 eV-1cm-3 und der Lage des Ferminiveaus zu charakterisieren. Für sehr geringe a‑Si:H Schichtdicken erhält man im Spektrum zusätzliche Beiträge aus dem Valenzband des darunterliegenden c‑Si Substrats, was eine einfache Bestimmung des Bandoffsets am a‑Si:H/c‑Si Heterokontakt mit einem Minimum von Annahmen ermöglicht [5,6].
2 Der Grund hierfür liegt darin, dass die niedrige Energie der Elektronen nicht ausreicht, um im Probenmaterial Phononen anzuregen, und damit der wesentliche inelastische Streuprozess nicht stattfinden kann.
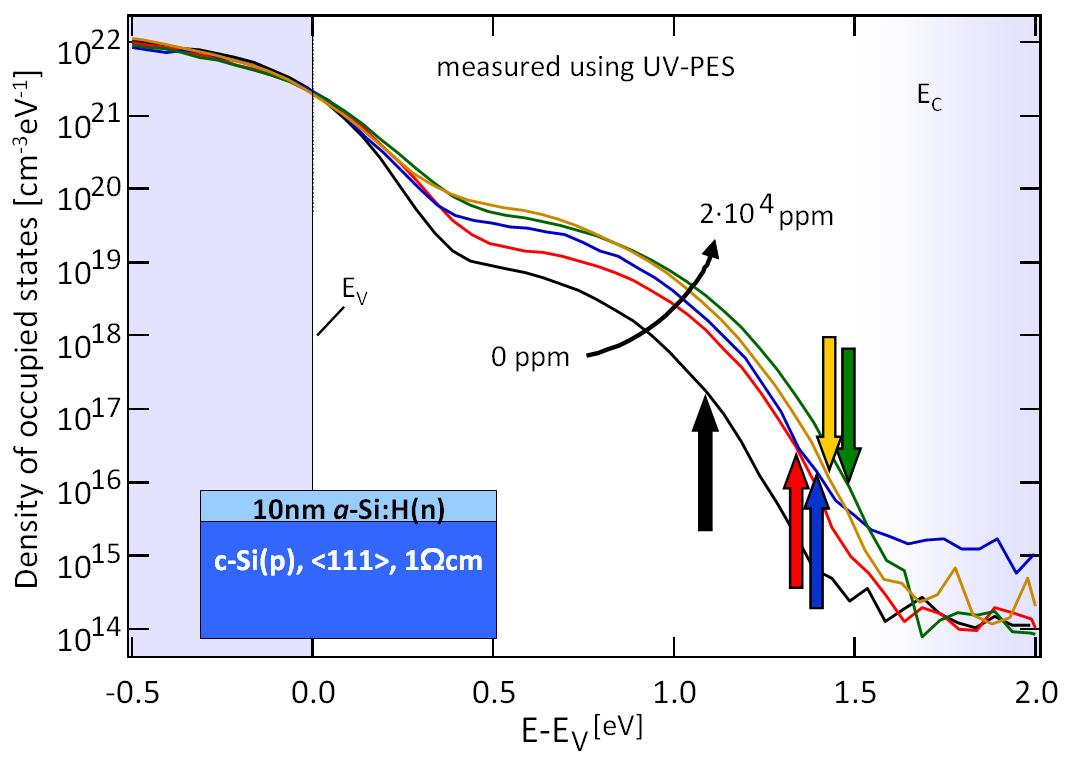
Beispiel einer CFSYS-Messung an unterschiedlich dotierten, ~10 nm dünnen a-Si:H Schichten auf kristallinem Silizium-Substrat (c-Si) [6]: EV markiert die Valenzbandkante des a-Si:H. Mit steigender n-Typ Dotierung des a-Si:H erhöht sich die Defektdichte in der Bandlücke, und das Ferminiveau EF (senkrechte Pfeile) verschiebt sich in Richtung Leitungsband-Kante EC. Zustände oberhalb von EF sind in der Photoelektronenspektroskopie nicht sichtbar, da nicht von Elektronen besetzt.
Literaturangaben:
|
[1] |
L. Korte; A. Laades & M. Schmidt, J. Non-Cryst. Sol. 352 (2006) 1217-20 |
|
[2] |
M. Schmidt; A. Schoepke; L. Korte; O. Milch & W. Fuhs, J. Non-Cryst. Sol. 338-340 (2004) 211-214 |
|
[3] |
K. Winer & L. Ley, Phys. Rev. B 36 (1987) 6072 |
|
[4] |
L. Korte & M. Schmidt, J. Appl. Phys. 109 (2011) 063714-1-6 |
|
[5] |
M. Sebastiani; L. D. Gaspare; G. Capellini; C. Bittencourt & F. Evangelisti. Phys. Rev. Lett. 75 (1995) 3352-5 |
|
[6] |
L. Korte & M. Schmidt, J. Non-Cryst. Sol. 354 (2008) 2138-43 |
